엘비세미콘
★무엇을 하는 회사인가?
-DDI , PMIC, CIS 등 비메모리 후공정 사업을 영위.
-PMIC 테스트 : 삼성전자 오스틴 공장 출고 PMIC
★사업내용
1) Bumping
- Au bump : TCP(Tape Carrier Package), COG(Chip on Glass), COF(Chip on Film), COP(Chip on Plastic) 패키지에 사용됨, 얇고 가벼운 특성으로 휴대용 제품에 적합
- Solder bump , Cu pillar bump
- WLCSP

2) Probe Test
- DDI, PMIC, CIS, SOC
3) Backend
- COG, T&R : 웨이퍼 테스트가 완료된 제품에 대해 고객 요청에 따라 Back Grinding, Laser Marking, Dicing Saw, Visual Inspection 제공하며, Packing(Tray or Tape & Reel) 공정을 포함하여 보관 및 배송까지 편리한 DropShip 서비스 제공

- Bump공정 및 WLCSP를하고 웨이퍼 테스트 및 COG Backend공정까지,
- 엘비루셈에서 COF와 패키징 테스트 수행.
★투자아이디어
1) 소재/부품사업자 부터 최종고객까지 네트워크 구축

2) OLED 패널시장 및 PMIC 시장의 성장
-엘지디스플레이(LX세미콘)와 삼성디스플레이를 고객으로 DDI 패키징 및 테스트 와 PMIC 범핑 및 테스트를 진행
-동사의 최종 어플리케이션은 DDI는 OLED스마트폰/TV, 네패스의 최대고객 삼성전자의 PMIC 범핑 일부 담당(삼성 오스틴 공장), 삼성전자의 CIS
-DDI 패키징 시장 1위
3) OLED 패널 DDI 채택 수량 증가

-Mobile에는 Gate-DDI, Source-DDI, Memory, T-Con, Power 기능등이 모두 들어간 1chip의 SoC 사용
-4k, OLED로 가면, PMIC, 다수의 Gate, Source DDI 사용되고, T-Con, PMIC(보통 Common으로 1개) 사용됨.
4)고객 다변화
- LG디스플레이, 삼성디스플레이, 중국등으로 다변화
5)고마진의 TEST 물량 확대
-2021년 신규투자했던 CIS 테스트장비가 2022년 부터 본격화되면서 고마진으로 인해 믹스 개선.
6) FO-WLP 개발중
-RFIC 및 PMIC쪽으로 확대, 현재 FO 방식으로 Single Die는 개발완료, 멀티다이 쪽 개발중
-최첨단 패키징 시장에 대응

★리스크
-전방시장의 악화
엘비루셈
★무엇을 하는 회사인가?
대형 DDI 중심의 패키징 및 Assembly, Test, Packing, DropShip 서비스 일괄 제공
★사업내용
- DDI란?
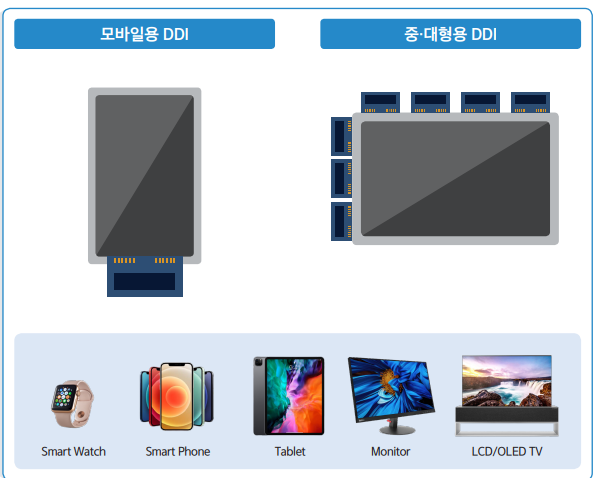

1) DDI(COF) 패키징 : 매출 98%
2)전력반도체 (MOSFET) 웨이퍼 가공
3)AOC : Active Optic Cable , 빛으로 대용량 데이터 전달, Data Center등에 적용
★사업구조


★투자아이디어
- 각종 모바일 및 전기차등 디스플레이 시장의 성장
- 중대형 OLED는 고해상, 고성능(방열, EMI차단)이 요구되어 DDI 가격상승
- 모바일은 OLED가 증가함에 따라 DDI 가격 상승과 수요증가, Bezeless가 요구됨에 따라 COF 수요 증가.
★리스크
-전방시장의 악화
'산업이야기 > 반도체 후공정' 카테고리의 다른 글
| 반도체 후공정 업체 간략 정리 ① -개요 및 '샘씨엔에스' (0) | 2023.02.15 |
|---|

댓글